半导体的性能在很大程度上取决于其封装组件的强度。如果没有耐用、可靠和高效的封装组件,半导体容易受到腐蚀、热、潮湿和物理冲击,以及与外部电路的连接减弱。
为了确保对器件的保护,许多半导体封装组件由工业强度环氧化合物组成,该化合物根据半导体在成品器件中的应用或物理位置提供物理保护和机械强度以及许多所需的性能。
环氧树脂是用于半导体封装组件的耐用环氧化合物的主要成分。因此,环氧树脂的性能直接决定了最终半导体封装组件的性能和特点。萘和双环戊二烯基环氧树脂通常用于这些包装组件,因为它们在苛刻的应用中具有优异的性能。这些环氧树脂由于其高耐热性,耐水性,延展性和粘接在苛刻的应用,如半导体封装,成型材料,电气层压板和航空航天应用,被认为是高性能的化学材料。
湿气和热量是环氧化合物配方的主要关注点,因为两者都可能破坏半导体,扭曲最终器件,甚至着火。虽然标准半导体采用铝散热器,但封装组件必须能够承受过多的内部热量,废物积聚,甚至可能来自外部环境的热量。半导体封装组件还必须能够承受潮气或成品设备的破坏风险。
半导体封装组件需要巨大的耐久性,必须能够同时承受多种元素。Sun化学先进材料公司的两种新型多功能萘基环氧树脂和一种新型双环戊二烯基环氧树脂将是本文的重点。这些树脂已被优化用于开发具有极高玻璃化转变温度和模量以及低熔体粘度、介电常数和吸湿性的半导体封装。
一种新型高模量环氧树脂
通常,萘基环氧树脂具有很高的阻燃性,但两种新的萘基环氧树脂,在此被称为环氧树脂N1和环氧树脂N2,也表现出异常高的玻璃化转变温度(Tg)。当使用酚醛固化剂和三苯基膦催化剂时,根据动态力学分析,环氧树脂N1的Tg为181°C,这是Tg测试最精确的方法。
虽然N1环氧树脂的Tg比N2低,但它具有更高的机械性能,特别是在使用二氨基二苯基砜固化体系时的高模量。图1和图2详细说明了与双酚a (BPA)环氧树脂和四功能环氧树脂相比,环氧树脂N1的高拉伸和弯曲强度。

图1:环氧树脂N1的抗拉强度。

图2:环氧树脂N1的抗弯强度。
除了半导体封装应用外,环氧树脂N1还优化用于半导体封装剂、先进复合材料、覆铜层压板(CCL)、各种薄膜和粘合剂。表1列出了N1型环氧树脂的一般性能。
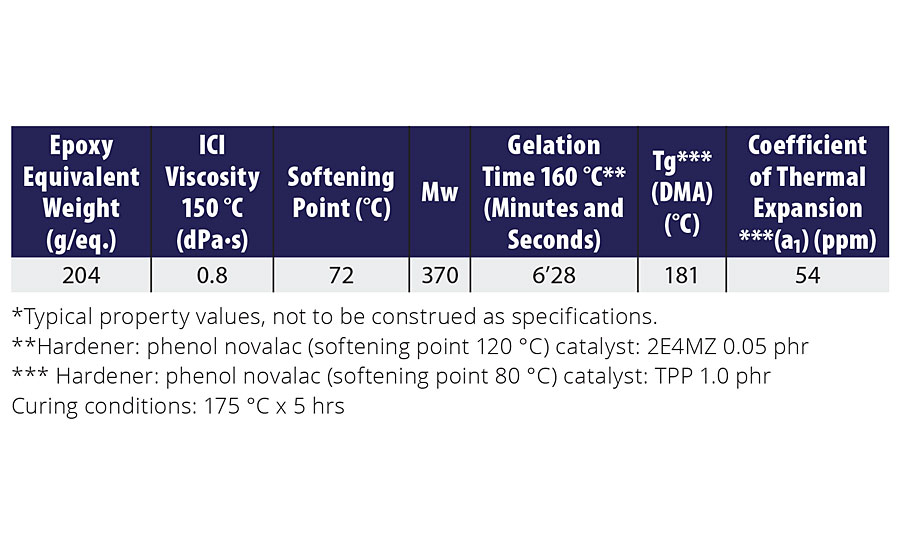
表1:环氧树脂N1的性能。
新型,多用途环氧树脂
有许多高性能的萘基环氧树脂可用于半导体封装组件,但相对较少能提供环氧树脂N2的可用性能范围。与N1环氧树脂类似,N2具有极高的Tg(196°C),同时还具有低熔体粘度、低热膨胀、低吸湿性、良好的溶解度和高粘接强度。
如表2所示,与联苯烷基酚醛环氧树脂相比,N2环氧树脂具有更低的熔体粘度、更低的热膨胀和更高的Tg。此外,环氧树脂N2可用于替代化学,具有较低的软化点和较低的熔体粘度-该版本的环氧树脂N2是半导体封装,覆铜层压板CCL等的理想选择。
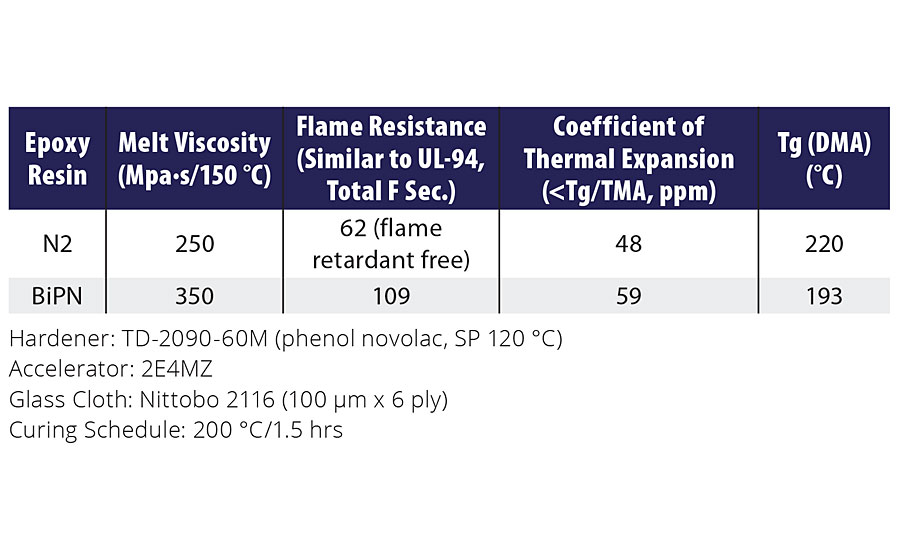
表2:环氧树脂N2与BiPN的熔体粘度、阻燃性、CTE和Tg。
环氧树脂N2是一种方便和通用的选择,适用于半导体封装组件的环氧体系配方。标准环氧树脂N2的性能是半导体封装组件的理想选择,如表3所示。
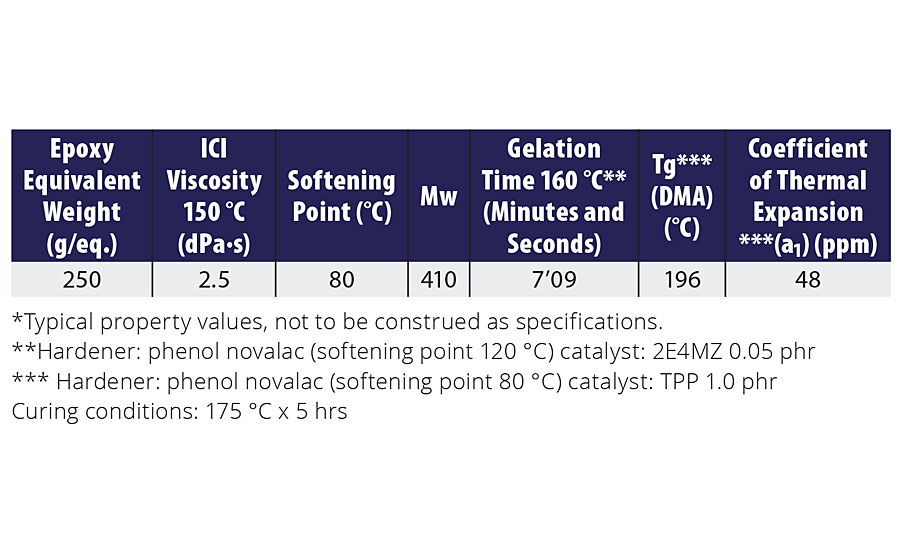
表3:环氧树脂N2的性能
新型超低吸湿环氧树脂
与N1和N2环氧树脂不同,新型二环戊二烯环氧树脂不具有高Tg和阻燃性。新型双环戊二烯基树脂在此被称为环氧树脂D1。
相反,环氧树脂D1针对半导体封装组件进行了优化,需要低吸湿性,低介电常数(Dk)和低耗散因子(Df)。低Dk和低Df值可以使半导体封装组件导电,并将破坏整个成品器件的可能性降至最低。
此外,环氧树脂D1具有一定的耐热性和低热膨胀性能,这是典型的双环戊二烯基化学物质。这降低了翘曲和破坏最终设备的风险。
如表4所示,环氧树脂D1有五个品种,在85℃温度和85%相对湿度条件下,300小时吸湿率从0.90%到1.07%不等。这五种化学物质在表4中被称为环氧树脂D1, D1a, D1b, D1c和D1d。
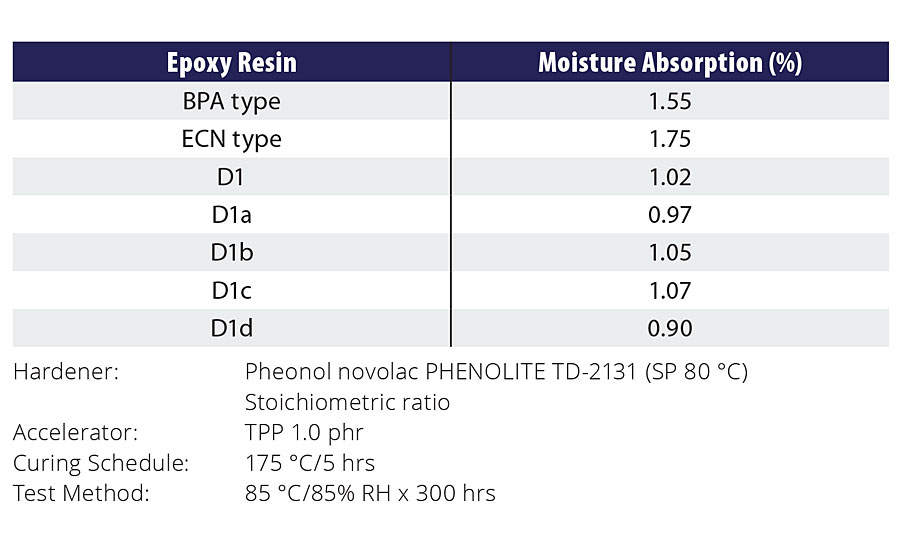
表4:环氧树脂D1的吸湿性。
与BPA和环氧甲酚酚醛树脂相比,环氧树脂D1的吸湿率相当低,接近一半。正如预期的那样,吸湿率较低的环氧树脂D1的熔体粘度、软化点和环氧当量重量也呈指数级增长,见表5。

表5:环氧树脂D1的性能。
环氧树脂D1的五种不同化学成分经过优化,适用于各种应用,包括半导体封装剂、薄膜、粘合剂和先进复合材料。此外,各种类型的环氧树脂D1含有不同水平的挥发性化合物,以满足全球监管机构的要求。
结论
半导体封装组件需要巨大的耐久性,以保护成品设备免受热、物理冲击、翘曲、静电和潮气的影响。因此,用于半导体封装组件的环氧化合物配方要求环氧树脂提供多种性能特征,这些性能特征取决于成品设备的应用或位置的要求。
这三种新型环氧树脂同时解决了半导体封装组件的多重挑战。
两种新型萘基环氧树脂被称为环氧树脂N1和N2,它们都具有极高的耐热性和高Tg,但在其他性能上差异很大。环氧树脂N1提供非常高的模量,使其成为需要韧性和灵活性的应用的理想选择。例如,工业电子设备和建筑设备必须抵抗物理接触和多年的大量使用。
相反,环氧树脂N2在本文所述的所有树脂中具有最高的Tg,但也是最通用的,具有令人印象深刻的性能能力,包括低熔体粘度、低热膨胀、低吸湿性、良好的溶解度和高粘接强度。环氧树脂N2是许多应用的理想选择,使其成为耐用和具有成本效益的半导体封装组件的全面选择。
这种全新的二环戊二烯环氧树脂,被称为环氧树脂D1,适用于海军电子设备,高湿度的位置,以及由于其低吸湿性,低介电常数和低耗散因子特性而具有不同寻常电气特性的半导体。
欲了解更多信息,请发电子邮件mark.edwards@sunchemical.com.







举报辱骂性评论